バッチ式自動洗浄装置
SCC-250
お問い合わせ

概要
- ラップ後洗浄装置:ラッピング砥粒除去(アルカリ+界面を主にした洗浄です)。
- アルカリエッチング洗浄装置:グラインディング後の加工歪を除去することを目的とした洗浄装置です。
- 熱処理前洗浄装置:RCA洗浄を基本としますが、ユーザーのライン構成により異なります。
- 熱処理後洗浄装置:RCA洗浄を基本としますが、ユーザーのライン構成により異なります。
- 研磨後洗浄装置:RCA洗浄が基本となります。(DHF・SC-1・SC-2・O₃処理)
- FINAL洗浄:RCA洗浄が基本となります。(DHF・SC-1・SC-2・O₃処理)
装置紹介
| シリコンウェーハ(8″・ 12″)バッチ式自動洗浄装置紹介 | |
|---|---|
| 幅広い分野の対応実績で、最適なカスタムを行うバッチ式装置。 | |
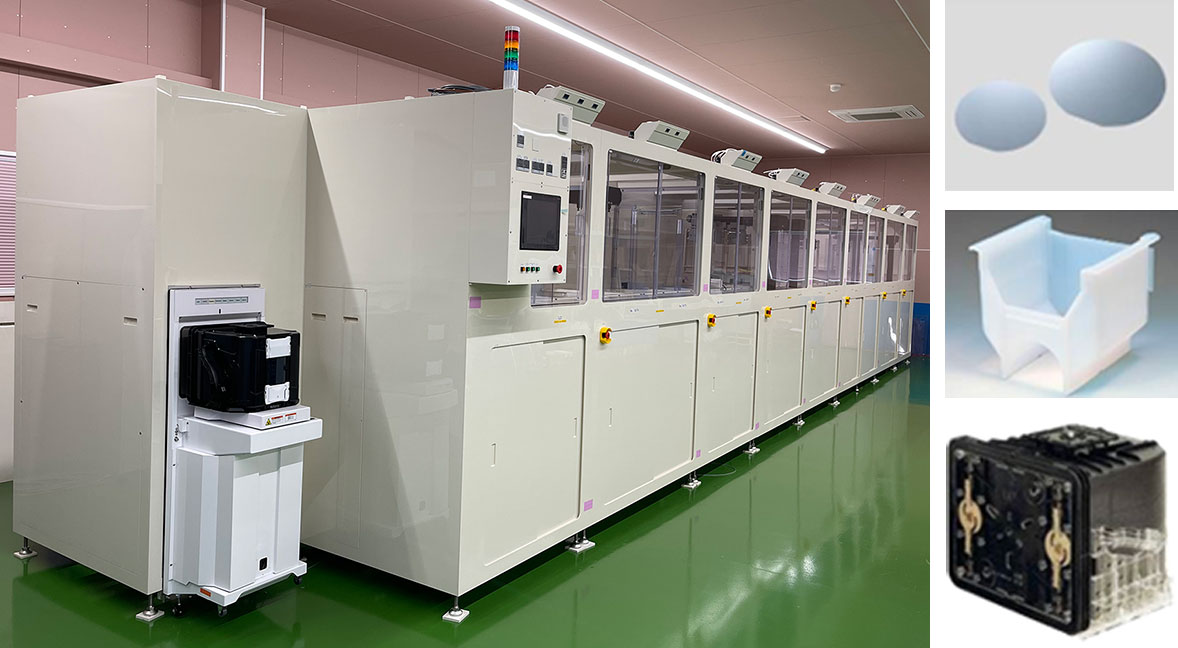 |
|
| 処理枚数 | 25枚・50枚の2種類です。 |
| 搬送方式 | キャリアタイプ・キャリアレスタイプから選択します。 |
| 洗浄方法 | 使用するプロセスに応じて洗浄槽の構成が決まります。 |
| ロボット | プロセスに応じて台数を決定します。 上下・走行・チャック駆動を備えております。 |
| LD&ULD |
PFA・OPEN・FOSB・FOUPカセットに対応します。 8″のウェーハピッチは、6.35mmです。 12″のウェーハピッチは、10mmです。 用途・レイアウトにより仕様を決定します。 |
| ピッチ変換 |
12″のウェーハ洗浄の場合、洗浄槽の容積を小さくするため ウェーハピッチを10mm~7mm又は5mmに変換します。 |
| 乾燥方法 | 温水引上乾燥・IR乾燥・スピンドライヤーから選択します。 |
| 装置全般 |
フレーム・架台 鉄骨溶接構造で耐食塗装後エンビ巻付け構造です。 上部には、FFU(クリーンユニット)を設置します。 |
| 処理時間 | 1バッチ(25枚又は50枚)5分(300sec)~6分(360sec)です。 |
| 装置仕様 | |
| ウエハーサイズ | φ200mm・φ300mm |
| ウエハ材質 | シリコン(SiCなどの化合物半導体は、別途仕様打合せ必要) |
| 処理槽及び構成 | ライン構成により別途仕様打合せ |
| HEPA又はULPA | 数量は構成により決定 |
| ロボット | PHT製又はPHOENIX ENGINEERING製:上下軸(ACサーボ駆動)+走行軸(ACサーボ駆動)+チャック機構(エア駆動) |
| 薬液 | O₃・HF・NCW・KOH・NH₄OH・H₂O₂・HCL・EDTA・HCL・クエン酸・DIW |
| 薬液温度 | 最大100℃まで対応可能 |
| 薬液槽 | 振子揺動・回転・超音波 |
| リンス槽 | バブリング、QDR、比抵抗計設置 |
| LD&ULD | イオナイザー(オプション) |
| 乾燥 | 温水引上・IR・スピンドライヤー・マランゴニー |
| 用力 | 純水, 窒素(エアセンサー用), クリーンエアー, 電源 , 真空(搬送用) |
| オプション設備 | オゾン発生装置 |
| PHT製の洗浄装置競争力 | |
|
洗浄装置は、各ユニットがモジュール化されています。 プロセスとしては、ワイヤーソー後洗浄・ラップ後洗浄機・アルカリエッチング洗浄・DSP洗浄・最終洗浄などです。ワイヤーソー後洗浄・DSP洗浄・FINAL洗浄が得意です。 |
|
| 特長 | |
| 高いプロセス性能 | シンプルな処理槽構造で最適なプロセスを実現します。 |
| ハイスループット | 槽間搬送は最短距離を最短時間にて搬送させる制御システム対応 |
| メンテナンス性の向上 | メンテナンス性を考慮した部品配置 |
| 装置設計 | 豊富な実験データに基づくプロセス最適化に向けた設計が可能 |
| 豊富な実績 | ニーズに合わせた最適なカスタム装置をご提供致します。 |
| 対応プロセス | |
| ワイヤーソー後洗浄・ラップ後洗浄・アルカリエッチング洗浄・熱処理前洗浄・熱処理後洗浄・研磨後洗浄・FINAL洗浄に対応します。 | |