枚葉式自動洗浄装置
お問い合わせ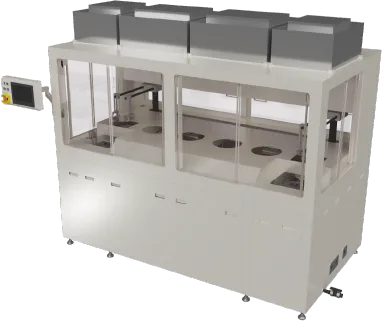
装置開発背景
半導体用基板として最も多く使用されているのはSi基板(シリコンウェーハ)である。近年では、パワー半導体用基板としてSiC基板(シリコンカーバイドウェーハ)が脚光を浴びている。基板の洗浄手段としては化学的洗浄と物理的洗浄の二つに大別される。
化学的洗浄:薬品によるエッチング等で基板表面を清浄にする手法。
物理的洗浄:超音波・高圧水等の物理的衝撃により基板表面のパーティクル等を除去する手法。
Si基板は主にRCA洗浄に代表される化学的洗浄を用いて洗浄を行っている。一部の洗浄においては、超音波を加え化学的洗浄と物理的洗浄を組み合わせる事でより洗浄効果を上げている。
SiC基板は化学的に安定した基板である。その為にSi基板と同じ手法ではその洗浄効果をあげることは困難である。しかし、Si面に酸化膜を形成することにより、化学的洗浄が可能となり、洗浄効果をあげる事ができると考えられる。
- SiCウェーハ洗浄の基本手法
- Si面にO3水を用いて強制的にSiO2膜を形成する。HFにてSiO2膜を除去。
概要
本装置は、φ150mm(6") ・φ200mm(8")対応の SiCウェーハ枚葉式洗浄装置です。
ウェーハは、25枚入カセットでLD側に作業者がセットします。洗浄後のウェーハは、ULD側にセットされたクリーンなカセットに収納されます。
- プロセス
- LD(水中)→ 両面ブラシスクラブ → 両面ブラシスクラブ → 超音波シャワー洗浄 → スピン乾燥 → ULD(空中)となります。
- 【処理物】
-
1. SiCウェーハφ150mm・φ200mm ノッチ・オリフラ直径φ150mm±0.2mm φ200mm±0.2mm厚さ385~600μm反り40μm以下接触可能範囲エッジ部及び外周から2mmの範囲
-
2. カセット
LD側カセット SEMI規格品 25枚収納 PFA
ULD側カセット SEMI規格品 25枚収納 PP
φ150mm(6")ウェーハ収納ピッチ 4.7625mm
φ200mm(8")ウェーハ収納ピッチ 6.35mm
- 【スループット】
-
タクトタイム:60秒/1枚 φ150mm(6")
タクトタイム:45秒/1枚 φ200mm(8")