Batch Type Wafer Cleaner SCC-250
Contact us
Overview
- Cleaning device after lapping: Removal of lapping abrasive grains (cleaning mainly with alkaline + interface).
- Alkaline etching cleaning equipment: Cleaning equipment for the purpose of removing processing distortion after grinding.
- Pre-heat treatment cleaning equipment: Basically RCA cleaning, but it depends on the user's line configuration.
- Post-heat treatment cleaning equipment: Basically RCA cleaning, but it depends on the user's line configuration.
- Post-polishing cleaning equipment: RCA cleaning is the basis. (DHF/SC-1/SC-2/O3 treatment)
- FINAL cleaning: RCA cleaning is the basis. (DHF/SC-1/SC-2/O3 treatment)
Equipment introduction
| Silicon wafer (8″・12″) batch type automatic cleaning equipment introduction | |
|---|---|
| A batch-type device that performs optimal customization with a track record in a wide range of fields. | |
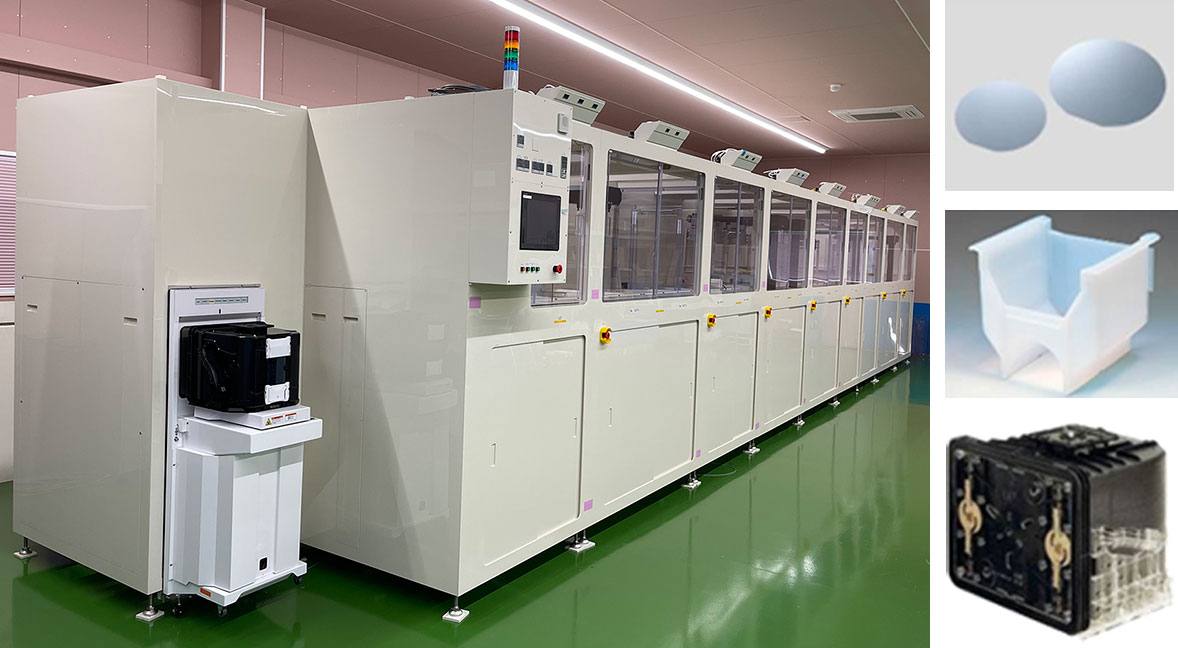 |
|
| Number of sheets processed | There are two types, 25 sheets and 50 sheets. |
| Conveying method | Select from carrier type or carrierless type. |
| Cleaning method | The process used determines the composition of the cleaning bath. |
| Robot | Decide the number according to the process. Equipped with up/down, travel, and chuck drive. |
| LD&ULD |
Compatible with PFA, OPEN, FOSB, and FOUP cassettes. The 8″ wafer pitch is 6.35mm. The 12″ wafer pitch is 10mm. The specifications are determined according to the application and layout. |
| Pitch conversion |
In the case of 12″ wafer cleaning, in order to reduce the volume of the cleaning tank Convert wafer pitch from 10mm to 7mm or 5mm. |
| Drying method | Select from hot water drying, IR drying, and spin dryer. |
| Equipment in general |
Frame/Stand A steel-frame welded structure that is wrapped around after corrosion-resistant coating. FFU (clean unit) is installed on the upper part. |
| Processing time | 1 batch (25 sheets or 50 sheets) 5 minutes (300 sec) to 6 minutes (360 sec). |
| Equipment specifications | |
| Wafer size | φ200mm・φ300mm |
| Wafer material | Silicon (Compound semiconductors such as SiC require a separate meeting for specifications.) |
| Treatment tank and configuration | Separate specification meeting depending on line configuration |
| HEPA or ULPA | Quantity determined by configuration |
| Robot | PHT or PHOENIX ENGINEERING: Vertical axis (AC servo drive) + travel axis (AC servo drive) + chuck mechanism (air drive) |
| Chemical solution | O₃・HF・NCW・KOH・NH₄OH・H₂O₂・HCL・EDTA・HCL・Citric acid・DIW |
| Chemical solution temperature | Capable of handling up to 100°C |
| Chemical bath | Pendulum swing/rotation/ultrasound |
| Rinse bath | Bubbling, QDR, resistivity meter installation |
| LD&ULD | Ionizer (option) |
| Drying | Hot water extraction/IR/Spin dryer/Marangoni |
| Utilities | Pure water, nitrogen (for air sensor), clean air, power supply, vacuum (for transfer) |
| Optional equipment | Ozone generator |
| Process performance specification | |
| Adhering particle count | 10 pieces/wafer (size of 0.15um or more) or less However, it is affected by the user's facility. |
| Metal contamination | Out of warranty |
| Etch uniformity | Out of warranty |
| Competitiveness of cleaning equipment made by PHT | |
|
Each unit of the cleaning equipment is modularized. The processes include cleaning after wire saw, cleaning after lapping, alkaline etching cleaning, DSP cleaning, and final cleaning. We are good at post-wire saw cleaning, DSP cleaning, and FINAL cleaning. In general, wafer cleaning (final cleaning) is considered NG (defective) if the number of particles on the surface of a φ300 mm wafer is less than 10. Particle size is 0.1μm or more. |
|
| Features | |
| High process performance | Realize the optimum process with a simple treatment tank structure. |
| High throughput | Conveyance between tanks is compatible with a control system that conveys the shortest distance in the shortest time. |
| Improved maintainability | Parts layout considering maintainability |
| Equipment design | Design for process optimization based on abundant experimental data is possible |
| Wealth of achievements | We will provide the most suitable custom equipment according to your needs. |
| Correspondence process | |
| We support cleaning after wire saw, cleaning after lapping, alkaline etching cleaning, cleaning before heat treatment, cleaning after heat treatment, cleaning after polishing, and final cleaning. | |